吉時(shí)利源表在半導(dǎo)體分立器件 I-V特性測(cè)試方案
半導(dǎo)體分立器件是組成集成電路的基礎(chǔ),包含大量的雙端口或三端口器件,如二極管,晶體管,場(chǎng)效應(yīng)管等。直流I-V測(cè)試則是表征微電子器件、工藝及材料特性的基石。通常使用I-V特性分析,或I-V曲線,來決定器件的基本參數(shù)。微電子器件種類繁多,引腳數(shù)量和待測(cè)參數(shù)各不相同,除此以外,新材料和新器件對(duì)測(cè)試設(shè)備提出了更高的要求,要求測(cè)試設(shè)備具備更高的低電流測(cè)試能力,且能夠支持各種功率范圍的器件。
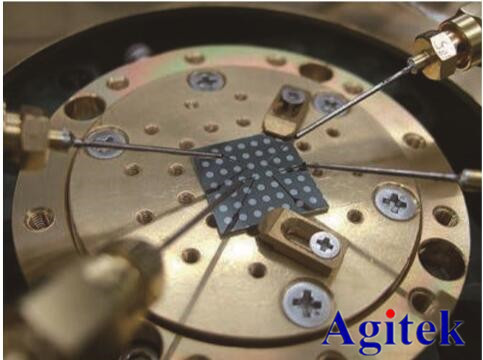
分立器件I-V特性測(cè)試的主要目的是通過實(shí)驗(yàn),幫助工程師提取半導(dǎo)體器件的基本I-V特性參數(shù),并在整個(gè)工藝流程結(jié)束后評(píng)估器件的優(yōu)劣。
隨著器件幾何尺寸的減小,半導(dǎo)體器件特性測(cè)試對(duì)測(cè)試系統(tǒng)的要求越來越高。通常這些器件的接觸電極尺寸只有微米量級(jí),這些對(duì)低噪聲源表,探針臺(tái)和顯微鏡性能都提出了更高的要求。
半導(dǎo)體分立器件I-V特性測(cè)試方案,泰克公司與合作伙伴使用泰克吉時(shí)利公司開發(fā)的高精度源測(cè)量單元(SMU)為核心測(cè)試設(shè)備,配備使用簡(jiǎn)便靈活,功能豐富的CycleStar測(cè)試軟件,及精準(zhǔn)穩(wěn)定的探針臺(tái),為客戶提供了可靠易用的解決方案,極大的提高了用戶的工作效率。
I-V特性測(cè)試難點(diǎn):
1、種類多
微電子器件種類繁多,引腳數(shù)量和待測(cè)參數(shù)各不相同,此外,新材料和新器件對(duì)測(cè)試設(shè)備提出了更高的要求,要求測(cè)試設(shè)備具備更高的低電流測(cè)試能力,且能夠支持各種功率范圍的器件。
2、尺寸小
隨著器件幾何尺寸的減小,半導(dǎo)體器件特性測(cè)試對(duì)測(cè)試系統(tǒng)的要求越來越高。通常這些器件的接觸電極尺寸只有微米量級(jí),這些對(duì)低噪聲源表,探針臺(tái)和顯微鏡性能都提出了更高的要求。
I-V特性測(cè)試方案:
針對(duì)I-V 特性測(cè)試難點(diǎn),安泰測(cè)試建議可采用keithley高精度源測(cè)量單元(SMU)為核心測(cè)試設(shè)備,配備使用簡(jiǎn)便靈活、功能豐富的 CycleStar 測(cè)試軟件,及精準(zhǔn)穩(wěn)定的探針臺(tái)。

吉時(shí)利方案特點(diǎn):
豐富的內(nèi)置元器件庫,可以根據(jù)測(cè)試要求選擇所需要的待測(cè)件類型;
測(cè)試和計(jì)算過程由軟件自動(dòng)執(zhí)行,能夠顯示數(shù)據(jù)和曲線,節(jié)省了大量的時(shí)間;
精準(zhǔn)穩(wěn)定的探針臺(tái),針座分辨率可高達(dá)0.7um,顯微鏡放大倍數(shù)最高可達(dá)x195倍;
最高支持同時(shí)操作兩臺(tái)吉時(shí)利源表,可以完成三端口器件測(cè)試。
測(cè)試功能:
二極管特性的測(cè)量與分析
極型晶體管BJT特性的測(cè)量與分析
MOSFET場(chǎng)效應(yīng)晶體管特性的測(cè)量與分析
MOS 器件的參數(shù)提取
系統(tǒng)結(jié)構(gòu):
系統(tǒng)主要由一臺(tái)或兩臺(tái)源精密源測(cè)量單元(SMU)、夾具或探針臺(tái)、上位機(jī)軟件構(gòu)成。以三端口MOSFET 器件為例,共需要以下設(shè)備:
1、兩臺(tái)吉時(shí)利 2450 精密源測(cè)量單元
2、四根三同軸電纜
3、夾具或帶有三同軸接口的探針臺(tái)
4、三同軸T型頭
5、上位機(jī)軟件與源測(cè)量單元(SMU)的連接方式如下圖所示,可以使用LAN/USB/GPIB中的任何一個(gè)接口進(jìn)行連接。
系統(tǒng)連接示意圖:
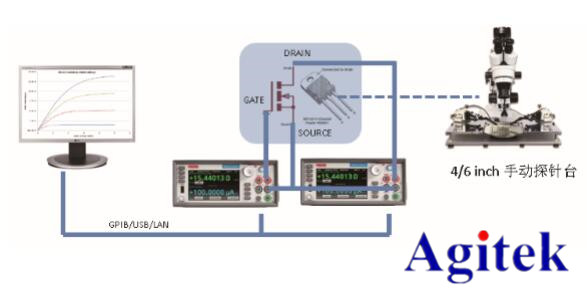
以上就是吉時(shí)利源表在半導(dǎo)體分立器件 I-V特性測(cè)試方案,更多信息歡迎登陸安泰測(cè)試。







 關(guān)注官方微信
關(guān)注官方微信
